гҖҖгҖҖзЎ…еӨ–延жүҖз”ЁиЁӯ(shГЁ)еӮҷиҰӢең�����пјҢдё»иҰҒз”ұеҸҚжҮү(yД«ng)еҷЁгҖҒеҠ зҶұиЈқзҪ��гҖҒж°Јй«”жҺ§еҲ¶зі»зө�(tЗ’ng)е’Ңж°«ж°ЈеҮҲеҢ–иЈқзҪ®зө„жҲҗгҖ�
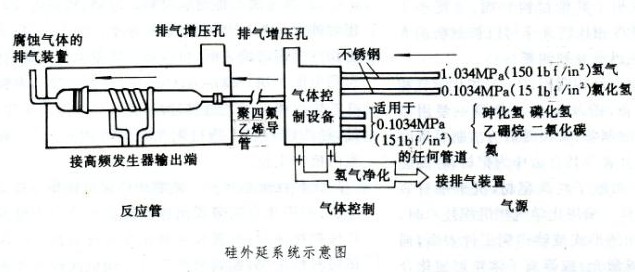
гҖҖгҖҖеҸҚжҮү(yД«ng)еҷ� дёҖиҲ¬зӮәзҹіиӢұеҲ¶е“Ғ��пјҢе…¶зө�(jiГ©)ж§�(gГІu)еҪўжҲҗз”ұжңҖеҲқзҡ„иҮҘејҸйҖҗжјёзҷ�(fДҒ)еұ•зӮәз«ӢејҸе’ҢжЎ¶еј�3зЁ�����гҖӮиҮҘејҸзӮәж°ҙе№іж”ҫзҪ®зҡ„зҹіиӢұз®Ў��пјҢзҸҫ(xiГ n)еӨҡзӮәзҹ©еҪўз®Ўд»Ҙж”№е–„еқҮеӢ»жҖ���пјӣж”ҫзҪ®иҘҜеә•зҡ„еҢ…иҰҶдәҶзўіеҢ–зЎ…зҡ„зҹіеўЁеҹәеә§зӣёе°Қж°ЈжөҒжңү3����гҖӮпҪһ5�гҖӮзҡ„еӮҫж–ңпјҢд»ҘеҲ©дәҺж”№е–„еқҮеӢ»жҖ����гҖӮзӮәйҖІдёҖжӯҘжҸҗй«ҳеӨ–延еұӨзҡ„еқҮеӢ»жҖ�����пјҢдҫҝеҮәзҸҫ(xiГ n)дәҶз«ӢејҸеҸҚжҮ�(yД«ng)еҷЁпјҢе…¶еӨ§еӨҡзӮәйҗҳзҪ©еҪ���пјҢеҹәеә§жҳҜж°ҙе№іж”ҫзҪ®зҡ„并еҸҜиҪү(zhuЗҺn)еӢ•зҡ„ең“зӣӨ�пјҢеҸҚжҮ�(yД«ng)ж°ЈжөҒиҲҮеҹәеә§иЎЁйқўеһӮзӣҙпјҢеӨ–延еұӨиЎЁйқўжҳ“еҸ—еҸҚжҮ�(yД«ng)ж°ЈжөҒдёӯйЎҶзІ’зҡ„ж’һж“Ҡе’ҢзҺ·жұ���гҖӮеӣ жӯ��пјҢиҮҘејҸеҸҚжҮ�(yД«ng)еҷЁдҫҝз•ҘеҚ е„�(yЕҚu)еӢҖҖӮзӮәзө�(jiГ©)еҗҲиҮҘејҸе’Ңз«ӢејҸдәҢиҖ…зҡ„е„�(yЕҚu)й»�����пјҢдҫҝжңүзӮәдәәеҖ‘жүҖжЁӮж„ҸдҪҝз”Ёзҡ„жЎ¶ејҸеҸҚжҮ�(yД«ng)еҷЁпјҢе…¶еӨ–еҪўиҲҮз«ӢејҸзӣёд»ҝ���пјҢдҪҶеҹәеә§зӮәеҸҜиҪ�(zhuЗҺn)еӢ•зҡ„зӣҙз«Ӣжҹұй«”�����пјҢе…¶ж°ЈжөҒе№іиЎҢдәҺеҹәеә§жҹұй«”иЎЁйқ������гҖӮеҸҚжҮ�(yД«ng)еҷЁзөҗ(jiГ©)ж§�(gГІu)жҳҜеҪұйҹҝеӨ–延еұӨеқҮеӢ»жҖ§е’Ңиі�(zhГ¬)йҮҸзҡ„йҮҚиҰҒеӣ зҙ ����гҖ�
гҖҖгҖҖеҠ зҶұиЈқзҪ® еӨ§еӨҡйҮҮз”Ёй«ҳй »ж„ҹжҮү(yД«ng)еҠ зҶұж–№ејҸпјҢй–“жҺҘең°еҠ зҶұиҘҜеә•�����гҖӮзӮәдҪҝеҠ зҶұеқҮеӢ������пјҢй«ҳй »еҠ зҶұз·ҡеңҲе’Ңеҹәеә§зҡ„зөҗ(jiГ©)ж§�(gГІu)еҪўзӢҖд»ҘеҸҠзӣёдә’й–“зҡ„еҢ№й…ҚжҳҜеҚҒеҲҶйҮҚиҰҒзҡ„�гҖӮеӣ й«ҳй »ж„ҹжҮү(yД«ng)еҠ зҶұжҳҜйҖҡйҒҺеҹәеә§иғҢйқўйҖІиЎҢзҡ„пјҢеҹәеә§е’ҢзЎ…зүҮй–“жңүжә«еәҰе·®����пјҢе®№жҳ“дҪҝзЎ…зүҮзҝ№жӣІ�����пјҢеј•иө·дҪҚйҢҜе’Ң滑移жҮ�(yД«ng)еҠ��пјҢзӮәе…ӢжңҚжӯӨзјәй»һпјҢеҗҺдҫҶдҫҝжңүзҙ…еӨ–иј»е°„еҠ зҶұзҡ„еҮәзҸ�(xiГ n)�пјҢ并已дҪҝз”ЁдәҺе·ҘжҘӯ(yГЁ)еҢ–з”ҹз”�(chЗҺn)зҡ„еӨ–延иЁӯ(shГЁ)еӮҷдёӯгҖ�
гҖҖгҖҖж°Јй«”жҺ§еҲ¶зі»зөұ(tЗ’ng) жҳҜз”ұеҗ„зЁ®й–Ҙй–Җ�гҖҒжөҒйҮҸиЁҲе’ҢиҖҗи…җиқ•жқҗж–ҷеҲ¶зҡ„зӣёйҖЈжҺҘжүҖзө„жҲҗзҡ„еҜҶе°ҒдёҚжјҸж°Јзҡ„зі»зө�(tЗ’ng)��гҖӮе®ғе°Қеҗ„зЁ®ж°Јй«”зҡ„жөҒйҮҸйҖІиЎҢзІҫеҜҶзҡ„жҺ§еҲ¶е’ҢиӘ�(diГ o)зҜҖ(jiГ©)����гҖӮжүҖз”Ёзҡ„й–Ҙй–ҖеҫһжңҖеҺҹе§Ӣзҡ„зҺ»з’ғиҖғж…®еҲ°еҗҺдҫҶйҮҮз”Ёзҡ„дёҚйҠ№йӢјй–Ҙ����гҖҒйӣ»зЈҒй–Ҙпјӣз®ЎйҒ“д№ҹз”ұеҺҹе…Ҳзҡ„еЎ‘ж–ҷз®��гҖҒзҺ»з’ғз®ЎгҖҒзҹіиӢұз®Ўзӯүиў«з•�(dДҒng)еүҚе»ЈжіӣйҮҮз”Ёзҡ„дёҚйҠ№йӢјз®ЎжүҖд»Јжӣҝ���пјӣжөҒйҮҸиЁҲд№ҹз”ұдёҖиҲ¬зҡ„иҪ�(zhuЗҺn)еӯҗжөҒйҮҸиЁҲзҷ�(fДҒ)еұ•еҲ°жҷ®йҒҚдҪҝз”Ёиі�(zhГ¬)йҮҸжөҒйҮҸиЁҲ���пјӣеҸҚжҮ�(yД«ng)ж°Јй«”зө„еҲҶд№ҹз”ұжүӢе·Ҙж“ҚдҪңиӘ�(diГ o)зҜҖ(jiГ©)зӮәиҮӘеӢ•жҺ§еҲ¶жүҖеҸ–д»ЈгҖ�
гҖҖгҖҖж°«ж°ЈеҮҲеҢ–иЈқзҪ® жҳҜд»Ҙеҗ„зЁ®еҗёйҷ„еҠ‘жҲ–йҲҖз®Ўе°Қж°«ж°ЈйҖІиЎҢеҮҲеҢ–д»ҘйҒ”еҲ°жүҖйңҖзҙ”еәҰ��гҖӮзӮәзҚІеҫ—иі�(zhГ¬)йҮҸе„Ә(yЕҚu)иү����гҖҒйҮҚзҸ�(xiГ n)жҖ§еҘҪзҡ„зЎ…еӨ–延зү������пјҢзҸҫ(xiГ n)д»Јзҡ„зЎ…еӨ–延иЁӯ(shГЁ)еӮҷе·ІиғҪе°Қж•ҙеҖӢеӨ–延全йҒҺзЁӢеҜҰзҸҫ(xiГ n)иҮӘеӢ•еҢ–зЁӢеәҸжҺ§еҲ���гҖ�
гҖҖгҖҖиі�(zhГ¬)йҮҸжҺ§еҲ� зЎ…еӨ–延зүҮиі�(zhГ¬)йҮҸзӣҙжҺҘеҪұйҹҝеҲ°еҷЁд»¶жҖ§иғҪ���гҖӮSiCl4зЎ…еӨ–延жҳҜдёҖеҖӢй«ҳжә«еҸҜйҖҶеҸҚжҮ�(yД«ng)зҡ„йҒҺзЁ����пјҢиҘҜеә•дёӯзҡ„йӣңиі�(zhГ¬)йҖҡйҒҺж“ҙж•ЈгҖҒи’ёзҷ�(fДҒ)���гҖҒиҮӘж‘»йӣңзӯүж•ҲжҮ�(yД«ng)��пјҢеҠ д№Ӣж°ЈжІ’иғҪеҸҠжҷӮиҝ…йҖҹең°жҺ’еҮәиҖҢйҖ жҲҗеӨ–延еұӨзҡ„дёҚеқҮеӢ������гҖӮйҮҮз”ЁSiH2Cl2е’ҢSiH4дҪңзӮәзЎ…жәҗ����пјҢдҪҝеҸҚжҮү(yД«ng)жә«еәҰйҷҚдҪҺ�����пјӣйҮҮз”ЁжёӣеЈ“еӨ–е»���пјҢе°ҮеҸҚжҮү(yД«ng)еҷЁдёҖйӮҠжҠҪз©����гҖҒдёҖйӮҠжҺ§еҲ¶йҖҡе…ҘеҸҚжҮү(yД«ng)еҷЁзҡ„ж°Јй«”жөҒйҮҸ�����пјҢдҪҝеҸҚжҮү(yД«ng)еҷЁе…§(nГЁi)зҡ„еЈ“еҠӣеңЁ8пҪ�20kPaзҡ„дҪҺеЈ“дёӢ�����пјҢйӣңиі�(zhГ¬)еҲҶеӯҗ�����гҖҒи…җиқ•жҖ§ж°Јй«”дҫҝиғҪиҝ…йҖҹйҡЁдё»ж°ЈжөҒжҺ’иө�����пјҢеҫһиҖҢжҠ‘еҲ¶дёҠиҝ°еӨҡзЁ®ж•ҲжҮ�(yД«ng)���гҖӮзЎ…еӨ–延еұӨзҡ„зјәйҷ·жңүиЁұеӨҡзЁ®�пјҢеҰӮеұӨйҢҜ���гҖҒдҪҚйҢҜзӯүжҷ¶ж јзјәйҷ·е’ҢеҠғз—�����гҖҒдә®й»һгҖҒи§’йҢ��гҖҒйң§зӢҖзӯүиЎЁйқўеҪўиІҢзјәйҷ·гҖӮиҘҜеә•еҲ¶еӮҷиіӘ(zhГ¬)йҮ�����гҖҒеҠ зҶұж–№ејҸгҖҒз”ҹй•·йҖҹеәҰ���гҖҒж°Јж°ӣе’Ңи©ҰеҠ‘зҙ”еәҰ�����гҖҒеҸҚжҮ�(yД«ng)е®Өзөҗ(jiГ©)ж§�(gГІu)д»ҘеҸҠж°Јзӣёи…җиқ•зӯүйғҪе°Қзјәйҷ·з”ў(chЗҺn)з”ҹзӣёжҮ�(yД«ng)зҡ„еҪұйҹ���гҖ�